摘要:华为“半导体封装”专利公布,先进封装、半导体材料、存储芯片等半导体板块迎反弹机遇。
天眼查显示,华为技术有限公司“半导体封装”专利公布,申请公布日为10月31日,申请公布号为CN116982152A。

专利摘要显示,本公开涉及一种半导体封装,该半导体封装包括:第一衬底、半导体芯片、引线框和密封剂。该密封剂的下主面包括在第一平面中延伸的第一部分、在第二平面中延伸的第二部分、在该第一平面与该第二平面之间的第一过渡区中延伸的第三部分,以及在该第二平面与至少一个引线之间的第二过渡区中延伸的第四部分。
该密封剂的该第一部分和该第一衬底的下主面在相同的第一平面中延伸,该第一平面形成该封装的下散热表面。该密封剂的该第二部分、该第三部分和该第四部分的尺寸被设置为在该密封剂的该第一部分与该至少一个引线之间保持第一预定义最小距离。
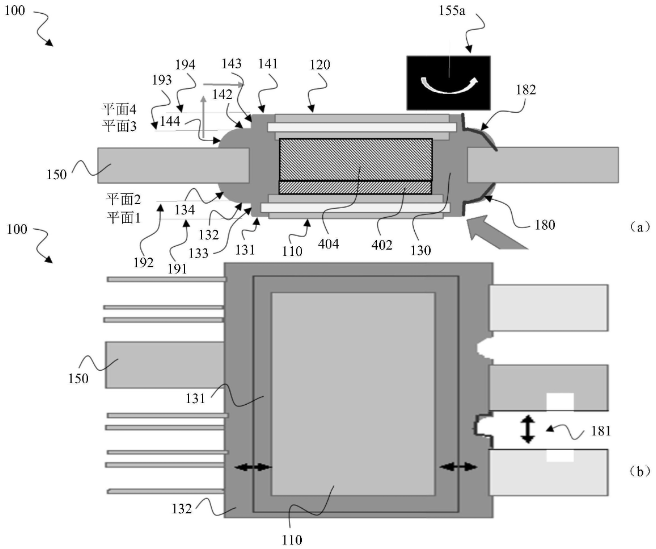
来源:财联社(12)

未经允许不得转载:财富在线科技 » 华为重大利好公布,这些板块迎反弹机遇!













